KRI 离子源应用于真空磁控溅镀设备 UHV Sputter
上海伯东代理美国 KRI 离子源应用于真空磁控溅镀设备 UHV Sputter 实现高质量薄膜!
真空环境的特征为其真空压力低于 10-8至10-12托, 且在化学, 物理和工程领域十分常见. 真空环境对于科学研究非常重要, 因实验通常要求在整个实验的过程中, 表面应保持状态并可使用较低能量的电子和离子的实验技术使用, 而不会受到气相散射的干扰并可以在这样真空环境下使用溅镀系统以提供高质量的薄膜.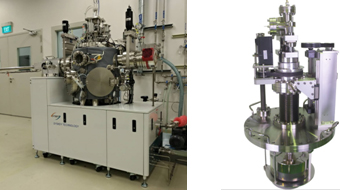
针对真空和高温加热设计的基板旋转镀膜机构, 使用陶瓷培林旋转, 并在内部做水冷, 来保护机构以确保长时间运转的稳定..jpg)
通过使用上海伯东 KRI 离子源可实现基板清洁和加速镀膜材料的溅射速度, 并且离子源在材料沉积过程中可帮助沉积并使沉积后的薄膜更为致密.
溅镀腔中在载台部分可独立施打偏压, 对其基板进行清洁与增加材料的附着性等功能.
上海伯东 KRI 射频离子源 RFICP 参数:
型号 | RFICP 40 | RFICP 100 | RFICP 140 | RFICP 220 | RFICP 380 |
Discharge 阳极 | RF 射频 | RF 射频 | RF 射频 | RF 射频 | RF 射频 |
离子束流 | >100 mA | >350 mA | >600 mA | >800 mA | >1500 mA |
离子动能 | 100-1200 V | 100-1200 V | 100-1200 V | 100-1200 V | 100-1200 V |
栅极直径 | 4 cm Φ | 10 cm Φ | 14 cm Φ | 20 cm Φ | 30 cm Φ |
离子束 | 聚焦, 平行, 散射 | ||||
流量 | 3-10 sccm | 5-30 sccm | 5-30 sccm | 10-40 sccm | 15-50 sccm |
通气 | Ar, Kr, Xe, O2, N2, H2, 其他 | ||||
典型压力 | < 0.5m Torr | < 0.5m Torr | < 0.5m Torr | < 0.5m Torr | < 0.5m Torr |
长度 | 12.7 cm | 23.5 cm | 24.6 cm | 30 cm | 39 cm |
直径 | 13.5 cm | 19.1 cm | 24.6 cm | 41 cm | 59 cm |
中和器 | LFN 2000 | ||||
上海伯东美国 KRI 提供霍尔离子源, 考夫曼离子源和射频离子源, 历经 40 年改良及发展已取得多项专利. 广泛用于离子清洗 PC, 离子蚀刻 IBE, 辅助镀膜 IBAD, 离子溅射镀膜 IBSD 领域, 上海伯东是美国考夫曼离子源中国总代理.
若您需要进一步的了解详细产品信息或讨论 , 请参考以下联络方式 :
上海伯东 : 罗先生 台湾伯东 : 王小姐
T: +86-21-5046-1322 T: +886-3-567-9508 ext 161
F: +86-21-5046-1490 F: +886-3-567-0049
M: +86 152-0195-1076 M: +886-939-653-958
www.hakuto-china.cn www.hakuto-vacuum.com.tw
伯东版权所有, 翻拷必究!